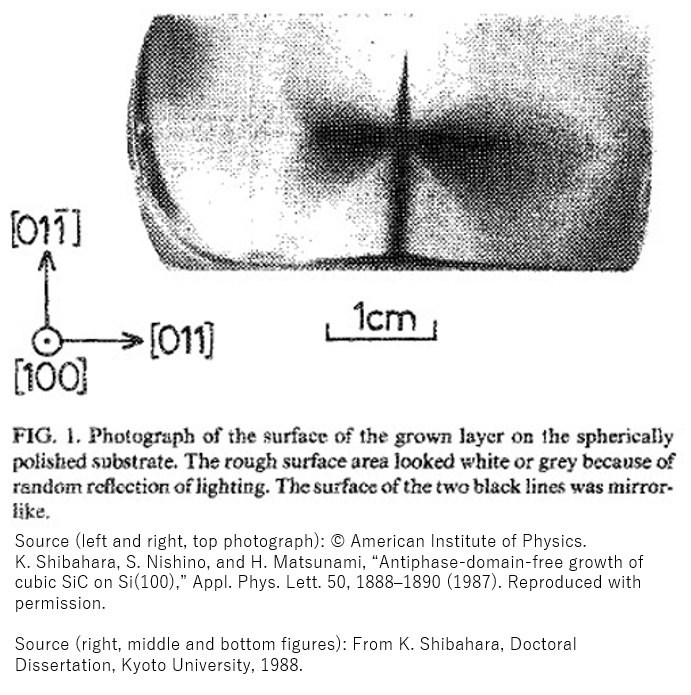

球面研磨を施した Si(100)基板上に 3C-SiC 薄膜結晶を成長させた試料の写真.
Si(100)面ジャスト(試料の中央部)上ではSiC表面が荒れるのに対し,(100)面から[011]方向に数度傾けた面上では表面の平坦な SiC 層が得られることを初めて見出した.この現象を,SiC 成長層中における APD(Anti-Phase Domain)発生の有無によることを結晶学的に解明した(1987 年).

Si(100)基板上に3C-SiC(100)がエピタキシャル成長する際に起こるAPDの生成機構を説明する模式図.
Si 基板表面の原子ステップの高さにより,APD(Anti-Phase-Domain)が発生しない場合((a))と発生する場合((b))が存在することを提案した(1986 年).
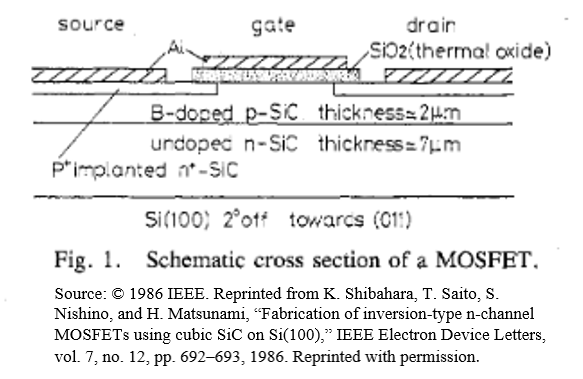
Si(100)基板上に成長した 3C-SiC(100)薄膜結晶を用いて作製した反転型MOSFET(MOS型電界効果トランジスタ)の断面模式図およびドレイン特性.
Bドーピングによる低濃度p型SiCの成長,Pイオン注入による低抵抗n型領域(ソーズ、ドレイン)の形成,熱酸化による良質な SiO2/SiC界面の形成など多くの技術を集約してSiC MOSFETが作製された.これは世界初の反転型SiC MOSFETとして当該分野の大きなマイルストーンとなっている(1986年).2001年以降,当該分野では 3C-SiC MOSFETのチャネル移動度が高いことが話題になっているが,1986 年,既に 100cm2/Vsを越えるチャネル移動度を報告している.
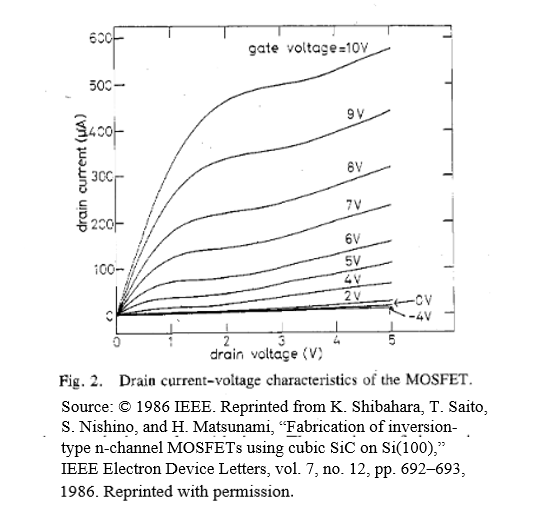
反転型MOSFETのドレイン電流-電圧特性
”Step-Controlled VPE Growth of SiC Single Crystals at Low Temperatures” DOI: 10.7567/SSDM.1987.C-4-2
全文(関連記事)
6H-SiC(0001)基板にオフ角を導入することにより、高品質 6H-SiC のホモエピタキシャル成長を初めて実現した「ステップ制御エピタキシー」の国際会議発表論文の題目部(1987 年).
今日の SiC パワーデバイス実用化の出発点となった当該分野最大のマイルストーンである.この研究業績に対して SSDM Award が 2005 年に授与された.
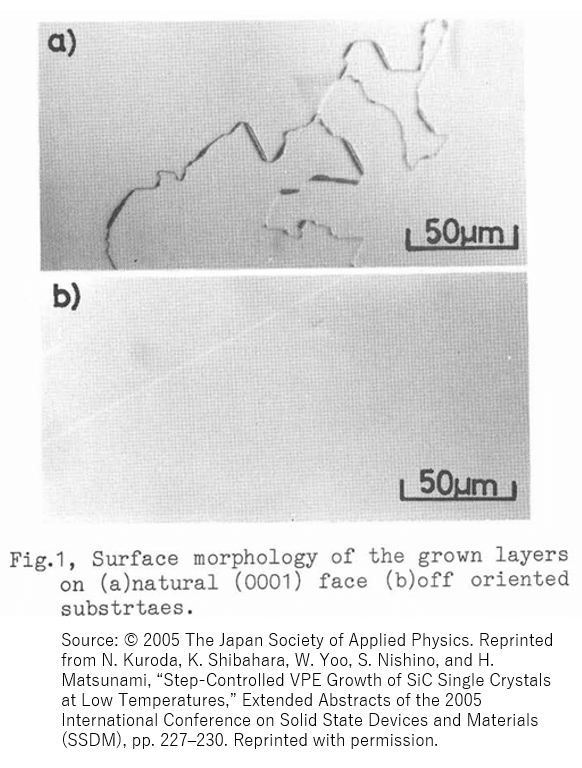
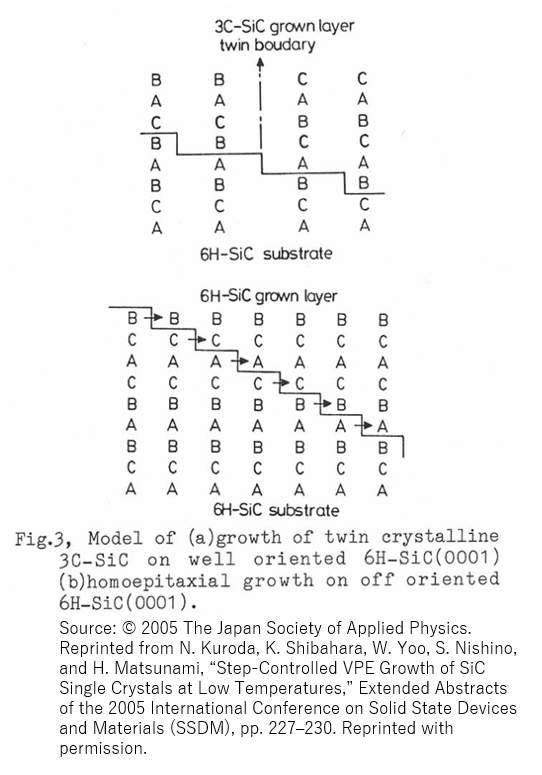
6H-SiC(0001)ジャスト面上では双晶境界の存在する 3C-SiC,6H-SiC(0001)オフ面上では表面の平坦な高品質 6H-SiC 結晶が成長する(ステップ制御エピタキシー).
各々の場合のSiC 成長結晶表面の顕微鏡写真,および成長メカニズムを説明する模式図(1987 年).
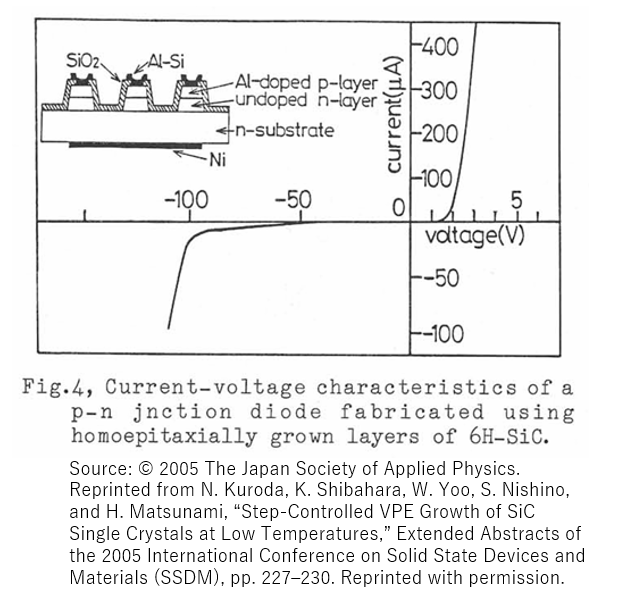
6H-SiC(0001)オフ面上に成長した高品質 6H-SiC 結晶を用いて作製したメサ形 pn ダイオードの断面模式図と電流―電圧特性(1987 年).
結晶の品質が高いため,当時としては例外的に優れたデバイス特性を示した.

SiC 結晶評価のために行った反射高速電子線回折(RHEED)像の例.
学生時代, RHEED の原理の物理的解釈,測定技術,分析力は既に超一流で,研究室の後輩に熱弁をふるった
参考研究会資料「RHEEDー基礎的理論と応用例」
ーーーーーーーー参考資料ーーーーーーーー
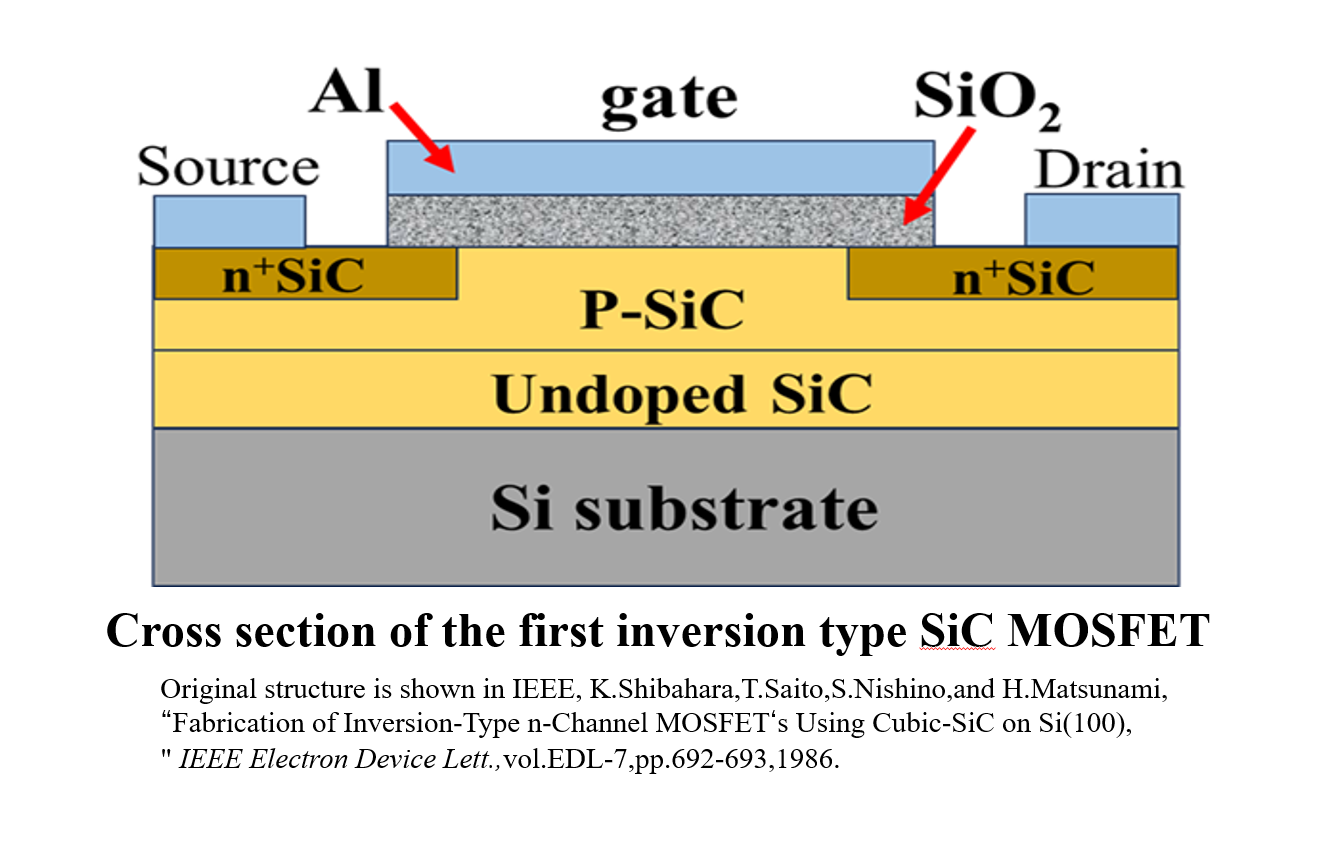
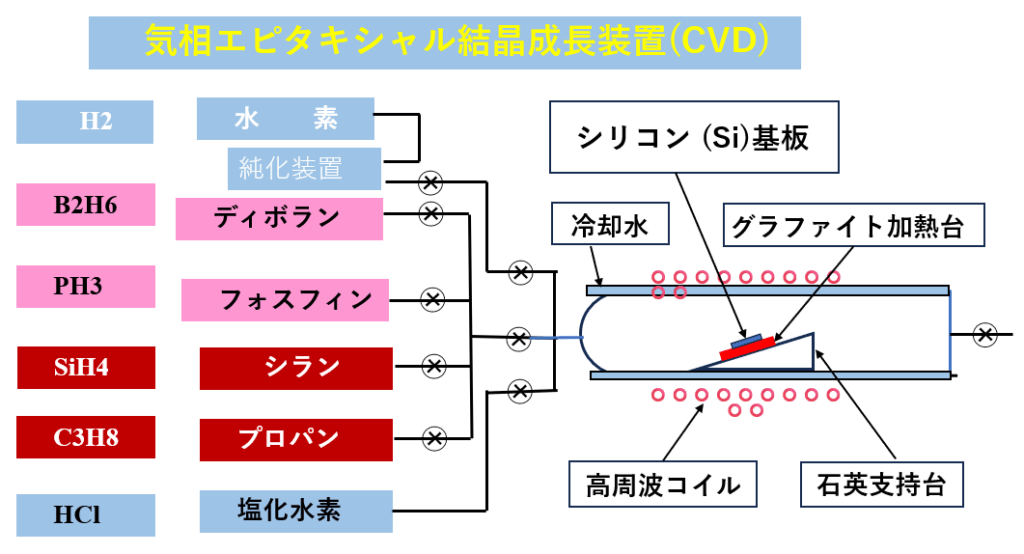

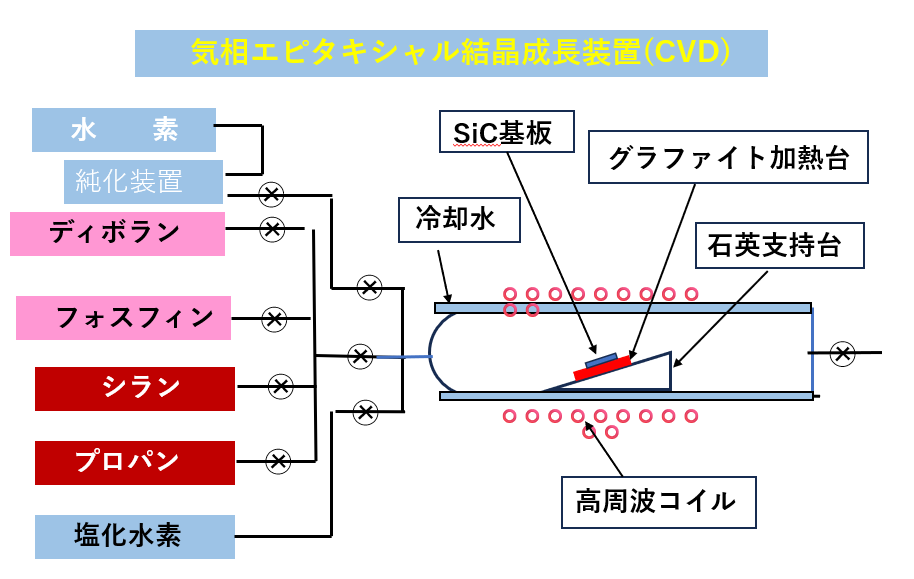
編集履歴:2026.1.18 キャプションを新しくしました。1/21キャプションを追加しました。リンクを更新しました。2/23 図を差し替えました。